揪出看不見的裂痕 晶圓切割有賴紅外線顯微鏡檢測
2025.07.16
晶圓切割(die saw)是半導體元件製造中封裝階段的過程,主要是將裸晶(die)從半導體成品晶圓上分離出來,後續才能被封裝到晶片載體並用於計算機等電子設備中。
隨著運算要求提高,晶片越趨精密,先進封裝在半導體製程重要性大幅上升;晶片的切割、揀選、黏晶等製程對於精度要求更是大大提高。但晶圓切割時,容易造成晶圓崩裂(chipping),尤其當晶圓薄化這類現象更容易發生,進而影響產品良率和性能。而有些切割雖然表面看不出有崩裂,但即使只有微小的表面瑕疵,也可能導致晶片功能失效。
除了切割技術的改良,切割後的檢測也是維持晶片良率的關鍵。晶圓切割後若發生隱崩情形,可使用紅外線IR顯微鏡或X-ray透視晶圓看到隱崩內部的裂痕。在表面看似完好的切割道中可用IR顯微鏡大範圍透視發現不同深度的隱崩,加上自動化(AOI/AI)的設備或使用PRECiV擴展景深功能,可在單一使用紅外線透視晶圓仍受到一些限制,如表面線路圖形造成繞射干擾,或是裂痕接近線路圖形時,加以探測不易發現的瑕疵。
MX63/MX63L IR可同時搭載可見光及紅外線光學系統,在可見光系統中使用微分干涉對比功能可以依晶片邊緣色彩的差異快速分辨出異常隱崩的位置,再使用IR顯微鏡功能判別裂痕深度及內部隱崩的情形。
在一般明視野可見光的觀察下,看到切割道邊緣並無異常(圖1);但在微分干涉的功能觀察下內有隱崩處有不同的高度差,造成干涉色彩差異,可由顏色快速辨識出隱崩位置(圖2、圖3)。
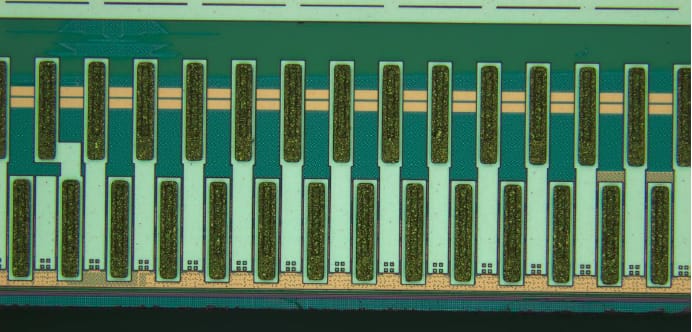
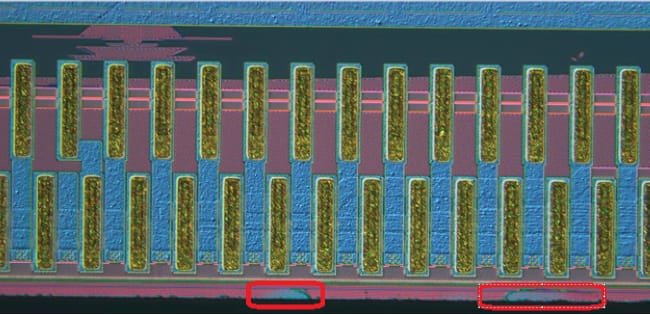
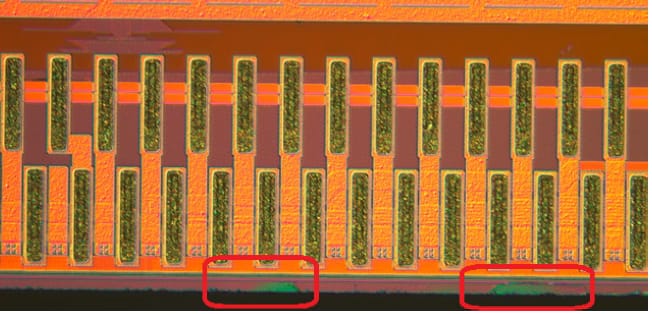
另外,搭配使用EVIDENT/OLYMPUS PRECiV 量測分析軟體可同時支援可見光及紅外線攝影機,可以很方便地切換兩種觀察方式做立即性分析,也可以搭載控制電動載物台做更有效率的檢查與分析。
對於愈來愈精密的晶圓封測品質、製程控制,利用顯微鏡針對PCB電路板上的IC晶片的內部線路缺陷和髒污狀況進行非破壞性檢測至關重要,是提升整體良率的重要幫手。
作者:工業應用部高級專員 張鴻翔/編輯:楊雅棠


