MIX觀察法 檢測晶圓缺失
2023.12.29
不同樣本的光特性不同,例如透明樣本和不透明樣本便存在差異。因此使用顯微鏡時有不同的觀察法對應特定的光特性,例如明視野、暗視野、偏振、干涉、螢光等。
明視野是用透射或反射光照亮樣本,並直接以物鏡收光,視野背景明亮,常用於染色樣本、病理樣本;在半導體檢測中則常用於觀察線路是否正常。
暗視野則是藉由暗視野環或暗視野聚光鏡,使投射到樣本光形成空錐狀,因此只有樣本散射或繞射的光會被收進鏡頭,視野背景成黑色,常用於觀察透明、無色的樣本;在半導體檢測中常用於觀察是否有刮傷及灰塵。

但在半導體檢測中,若能將明、暗視野觀察法結合起來,明視野可增強顏色等表面細節,暗視野可加強微小刮痕、缺陷等邊緣細節,使用者就能在單次檢測中觀察到更多樣本的情況,節省許多時間。
這種將不同觀察法結合在一起,便稱之為MIX照明或MIX技術。
除了明、暗視野結合的MIX技術外,將螢光和暗視野觀察法結合,也是半導體檢測中有用的方法。
螢光觀察法通常用於檢測殘留的抗蝕劑、有機溶劑等,但很難確認殘留物位置。因此若搭配暗視野觀察,則可同時確定晶圓上圖形相對位置以及汙染物的螢光影像。
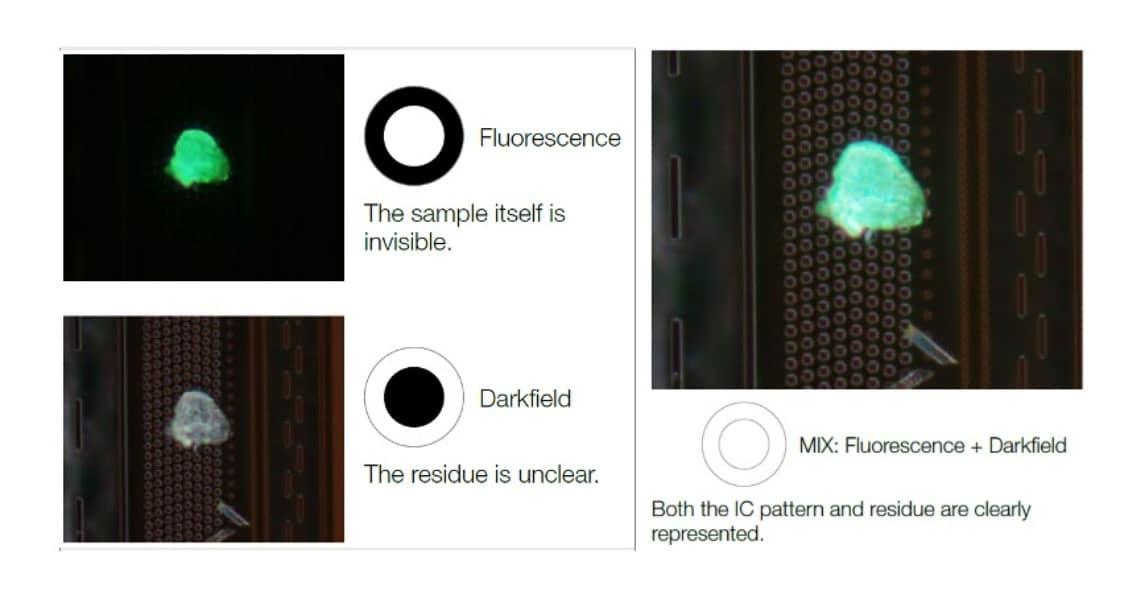
本文改寫自Mix Observation Methods to See More in Your Wafer Defect Inspection


